오늘은 "Principles of plasma discharges and materials processing"의 챕터 15 Etch부분을 공부해봅시다.
플라즈마 식각 요구조건 (Plasma etch requirements)
플라즈마 식각 프로세스에는 여러가지 요구 조건들이 있다: 식각 속도 (etch rate), 이방성 (anisotropy), 선택성 (selectivity), 웨이퍼 전반 균일성 (uniformity), 표면 질 (surface quality), 프로세스 재현성 (process reproducibility).
아래의 예로 요구 조건들을 하나 하나 살펴보자.

- 식각 속도 (etch rate)
: 상업적인 용도로 쓰일 때는 photoresist (PR)가 다 벗겨져야하고 polysilicon도 다 시각 되어야한다.
따라서 최소 식각 속도는
PR: 250 nm/min
Polysilicon: 50 nm/min
- 선택성 (selectivity)
: 위에 그림에서 polysilicon 대 PR 비율은 (100nm / 500 nm = 0.2)
따라서 polysilicon 100nm를 식각하면서 PR을 심각하게 건드리지 않기 위해서 최소 0.2의 선택성은 필요하다.
2~3 의 선택성이 허용되는 수준이다.
선택성에서 하나 더 고려해야 할 사항은 균일성 (uniformity) 부족에 따른 과다 식각 (overetch) 이다.
이 과다 식각 (overetch) 을 통해서 웨이퍼 모든 지역에서 식각이 다 안되고 남아있는 부분(unmasked area) 이 없게 하려는 것이다. 보통 20% 정도 더 식각 (overetch) 하기 때문에 여기서 생각해야될 선택성은
polysilicon 대 oxide 비율이다. 위 그림에서 보면 (0.2X100nm / 2nm = 10) polysilicon 대 oxide 식각 선택성 = 최소 10.
일반적으로 100~200 정도의 선택성이 필요하다.
- 이방성 (anisotropy)
이방성을 공부하기 위해서 아래 그림을 살펴보자.
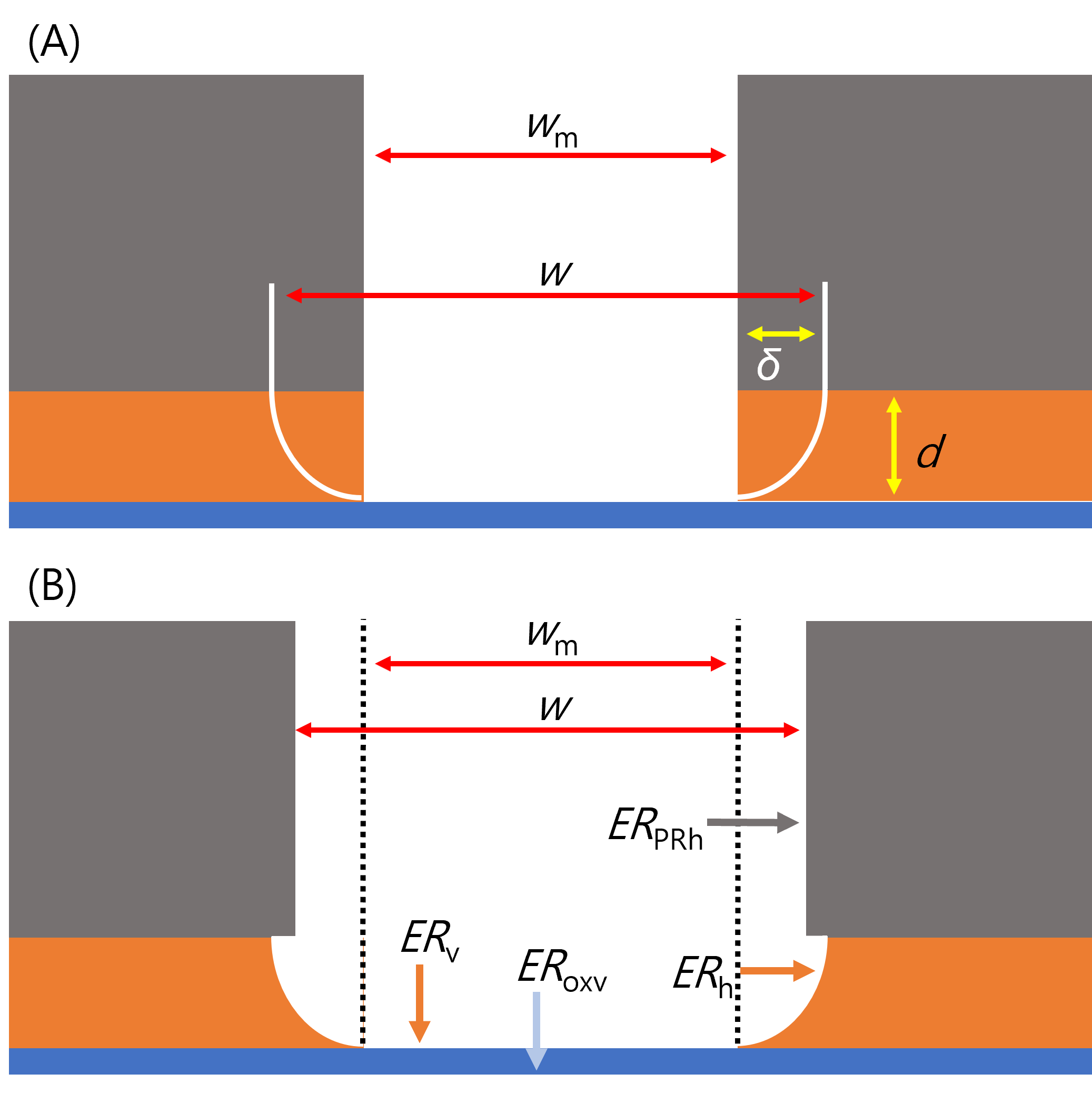
ERv = 수직 방향 식각 속도 (vertical etch rate)
ERh = 수평 방향 식각 속도 (horizontal etch rate)
w: 폭 (width)
wm: 최소 마스크 피쳐 사이즈 (minimum mask feature size)
d: 두께 (thickness)

깊게 식각하는 경우 (d/w >> 1), 이방성 요구 조건 (anisotropy requirement)는 더 엄격해진다.
- 균일성 (uniformity)
ER(PRh): 수평 방향 PR 식각 속도
ER(oxv): 수직 방향 oxide 식각 속도
S: selectivity (선택성)

이제는 Oxide sublayer의 식각을 살펴보자.
가장 빨리 polysilicon 식각이 끝나는 때는 polysilicon 두께가 가장 얇을때 + 식각 속도가 가장 빠를 때이므로...

마지막 식을 보게 되면 균일성 (uniformity = α+β)은 oxide layer 선택성 (oxide sublayer selectivity = ER(oxv)/ER(v))와 반비례 관계에 있게 된다.
여기 까지의 관계를 그래프로 살펴보면 아래와 같다.

수고 많으셨습니다.
'플라즈마 이야기' 카테고리의 다른 글
| Etch Processes 식각 공정 (0) | 2021.12.25 |
|---|---|
| Discharges (0) | 2021.12.22 |
| Sheaths (0) | 2021.12.21 |
| Plasmas (0) | 2021.12.21 |
| Plasma etch process (플라즈마 식각 공정) (0) | 2021.12.19 |



