오늘은 총 4가지의 식각공정에 대해 공부해보자.
Sputtering (스터퍼링), pure chemical etching (화학 반응에 의한 식각), ion energy driven etching (이온 에너지에 의한 식각), ion inhibitor etching (이온 억제제를 이용한 식각)
아래에 4가지 식각 공정에 대한 간단한 그림이 있다.

먼저 Spurttering에 대해 알아보자.
Sputtering은 강한 에너지를 가지는 이온으로 때려서 표면의 원자들을 날려보내는 방식이다.
수백 volts의 에너지를 가지는 이온들이 plasma discharge (플라즈마 방전)으로 부터 나온다.
이 공정은 선택적인 공정은 아니다 (unselective).
따라서 sputtering 속도는 보통 느린 편이며, 종류에 상관없이 거의 비슷하다.
하나의 이온이 하나의 원자를 날려보내는 정도?
하지만 sputtering은 굉장히 anisotropic (이방성) 한 공정이다. 왜냐하면 이온이 때리는 각도에 영향을 많이 받기 때문이다. 아래 논문의 결과 처럼 0도 에서 시작해서 식각 속도가 증가하다가 최고점을 찍고 감소하면서 90도에서 식각 속도가 0이 된다.

최고 식각 속도가 0도가 아니기 때문에 패턴이 이전(transfer)될때 완전하게 되지 않을 수가 있다.
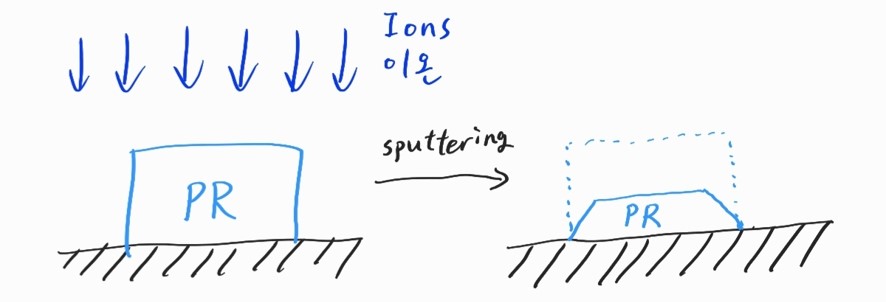
위에 그림 처럼 새로운 면이 생기게 되는데 역시 그 이유는 최고 식각 속도가 0도에서 일어나지 않기 때문이다
Sputtering은 4가지 식각 공정중 유일하게 휘발성이 아닌 생성물도 제거 할 수 있다.
하지만 이 경우 다시 증착 되는 (redeposition) 경우를 막기 위해 mean free path가 커야 하므로 낮은 압력에서 진행되야 한다.
두번째는 pure chimical etching (화학 반응에 의한 식각) 이다.
이 경우 기체 상태의 etchant 원자나 분자가 (식각액) 기판 (substrate)에서 화학 반응을 일으킴으로 식각 된다.
이 경우 기체상태의 etchant 원자나 분자가 기판에 닿는 것은 각도에 의존하지 않으므로 isotropic (등방성) 식각이 된다.
이 경우 생성물은 반드시 휘발성이어서 잘 날라가야 한다.

세번째는 Ion energy driven etching (이온 에너지에 의한 식각).
플라즈마 방전 (plasma discharge)이 강한 에너지의 이온 (energetic ion)과 식각 물질 (etchant)을 둘 다 제공한다.
이 경우 식각 속도는 아래와 같이 둘 중에 하나만 했을 때보다 훨씬 더 빠른 식각속도를 볼 수 있다.

연구에 의하면 식각은 화학적 반응에 의해 이뤄지고 반응 속도는 강한 에너지를 가진 이온의 충격 (energetic ion bombardment)에 의해 결정되어 지는 것처럼 보인다.
식각 후 생기는 생성물은 반드시 휘발성이어야 하고 잘 날라가야 한다. 이 경우도 이온이 때리는 방향성에 영향을 받기 때문에 굉장히 ansotropic (이방성을 띈) 하게 된다. 하지만 선택성 (selectivity) 에 관해서는 화학반응에 의한 식각보다는 안좋다.
마지막으로 Ion inhibitor etching (이온 억제제를 이용한 식각)이 있다.
이 경우 억제제 (inhibitor: 식각을 막는 물질)를 이용하게 된다.
플라즈마 방전이 etchant (식각 물질), 강한 에너지를 가진 이온 (energetic ion), 그리고 억제제의 전구 물질 (inhibitor precursor molecule) 을 제공한다.
이 억제제 전구 물질이 기판 (substrate) 표면에 증착 (deposition) 되거나 흡착 (adsorption) 되게 되고 보호막 (protective layer) 혹은 고분자 필름 (polymer film) 을 형성하게 된다.
예를 들어 알루미늄 (Al) 을 식각 할때 Cl이나 Cl2를 사용하게 되는데 이 경우 isotropic한 식각이 된다.
이때 탄소 (Carbon)을 feedgas (넣어주는 혼합 기체) 에 섞어 주게 되면 탄소와 염소로 구성된 고분자 필름 (chlorocarbon film)이 표면에 형성되게 된다.
식각 하는 부분은 ion bombardment 에 의해서 이 필름이 제거가 되지만 옆쪽에 있는 (sidewall) 보호막 같은 경우는 유지가 되서 식각 물질로부터 보호 된다.
그 결과 굉장히 anisotropic한 식각이 될 수 있다.
하지만 보호막으로 인한 기판의 오염과 마지막에 이 억제제 보호막을 제거하는 문제가 있다.
마지막으로 생성물이 휘발성인 식각 물질과 식각되는 물질에 대해서 알아보고 마치도록 하자.

참고문헌
M. Stepanova, S. K. Dew, and I. P. Soshnikov Phys. Rev. B 2002, 66, 125407.
J. W. Coburn and H. F. Winters J. Appl. Phys 1979, 50, 3189.
'플라즈마 이야기' 카테고리의 다른 글
| Plasma etch 1: requirements (0) | 2021.12.23 |
|---|---|
| Discharges (0) | 2021.12.22 |
| Sheaths (0) | 2021.12.21 |
| Plasmas (0) | 2021.12.21 |
| Plasma etch process (플라즈마 식각 공정) (0) | 2021.12.19 |



